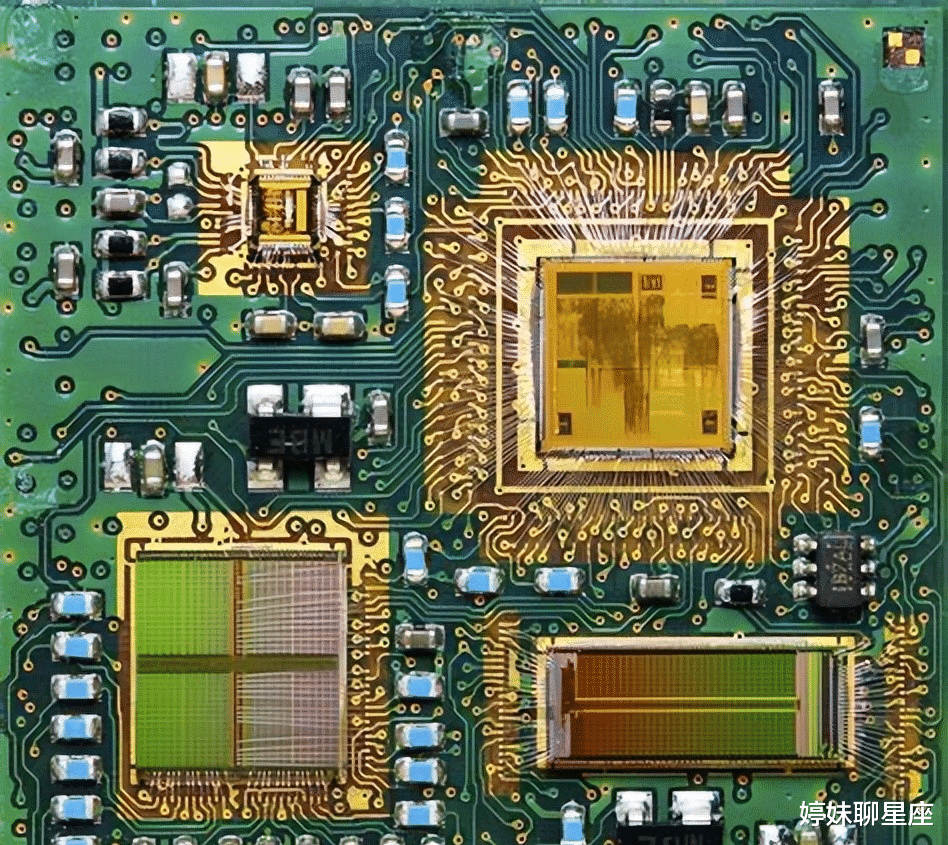
文章图片

文章图片
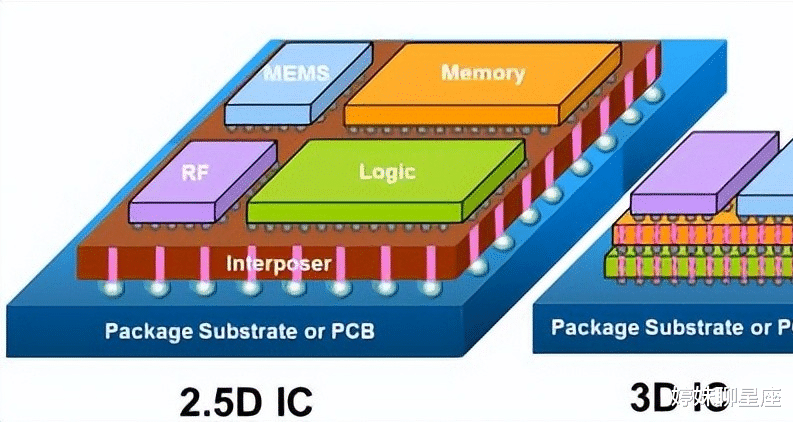
文章图片

文章图片
一、芯片封装技术
封装技术 , 是芯片产业必不可少的一环 , 就像人需要穿衣服一样 , 芯片生产出来需要封装 。 一个芯片生产出来不封装是无法直接使用的 , 封装既是对芯片的保护 , 也是为了给芯片提供一个对外交流的接口 。 封装的设计 , 就像给人穿衣服一样 , 要对芯片知冷知热 , 芯片工作时产生的热量必须通过封装外壳高效地传导出来 , 避免芯片烧毁 , 封装好的芯片可以隔绝空气减少元器件和电线氧化失效 。 同时 , 芯片封装又不仅仅是穿衣服那么简单 , 你可以理解成高档的灯具绝不是简单地把电灯泡包起来 。 通过封装 , 可以让多个芯片整合在一起 , 发挥1+1大于2的功效 。 对于有些领域 , 封装的成本甚至会超过芯片本身 , 可见芯片封装的重要性 。
早期的芯片封装确实比较简单 , 只是把芯片给包装起来 , 并给芯片提供一个对外的接口 。 大家看过电路板的话 , 那些有两排插脚像短蜈蚣一样的元器件 , 就是使用早期的封装技术 。 但是随着芯片性能的不断提高 , 早期的封装技术就远远无法符合要求了 。 后来有了方形芯片四面都是插脚的封装方式 , 再后来又发展出了焊球阵列封装 。 从外观上看只是接口形式的变化 , 但是从内部看却越来越复杂 。
芯片封装从单芯片封装过渡到多芯片封装再到系统级封装 。 单芯片封装方面 , 从注重接头效率 , 到注重封装效果 , 比如芯片尺寸封装 , 像手机这样的设备要求封装以后的芯片越小越好 , 也就是芯片封装外壳越小越好 , 哪怕封装后的芯片比别人大一点或者厚一点 , 都有可能成为被客户放弃的理由 。 当初台积电从三星手里面抢夺苹果订单 , 就是依靠理念更先进的封装技术 。
二、多芯片封装和异构封装
多芯片封装方面 , 从水平排列封装 , 到三维叠加封装 , 再到多维异构封装 。 所谓的多维封装 , 就是相对于二维封装来说的 。 二维封装是让多个芯片并列摆放 , 芯片越多 , 封装出来的产品越大 , 在电路板上非常占用空间 。 为了减少尺寸就会用到多维封装 , 就是把芯片摞起来 , 不增加面积 , 只增加厚度 。 大家千万不要以为立体封装就是把几个芯片摞在一起就可以了 。 摞在一起的芯片怎样散热 , 线路怎样连接 , 如何减少厚度 , 相互之间怎样减少干扰 , 都是需要考虑的问题 。
其实 , 三维叠加封装主要应用在结构比较简单的存储芯片领域 , 更复杂的芯片需要更复杂的封装方式 , 也就是多维异构封装 。
所谓的异构封装 , 就是把不同生产工艺甚至不同材料的芯片封装在一起的技术 , 主要应用于系统级芯片的封装 。 所谓系统级芯片 , 我们拿手机芯片来举例 , 手机芯片已经不再是传统意义上的CPU , 而是把CPU、GPU、AI芯片、内存、甚至通信芯片、电源控制芯片等整合到一起的系统级芯片 。 这些芯片本身并不是一起生产出来的 , 生产工艺不一样 , 甚至生产材料都不一样 , 能不能有机整合到一起 , 就看封装的水平了 。
- 小程序|如何实现从小程序跳转到网页?
- 联发科|Apple Watch将采联发科Modem芯片?联发科回应
- |全球芯片过剩已成必然
- CPU|CPU价格将上涨!AMDIntel芯片变得更昂贵,准备好你的钱包
- 微软|降至2259元,150W秒充+天玑8100+独显芯片,谁说便宜没好货?
- 芯片|郭台铭按下暂停键,夏普大阪堺市10代厂连赚3年后惨变赔钱货
- 芯片|你所不知道的芯片国产化替代狂潮
- 芯片|字节回应自研芯片:对CPU/GPU“不感冒”
- 华为荣耀|荣耀Magic5至臻版曝光:18+1TB顶配组合,3nm芯片跑分115万
- 华为鸿蒙系统|不用华为鸿蒙,小米基于安卓,也实现了“超级终端”功能?
