书籍:《炬丰科技-半导体工艺》
文章:在HF溶液中蚀刻期间GaAs上的砷形成
编号:JFKJ-21-887
作者:炬丰科技
引言
【 浓度|《炬丰科技-半导体工艺》在HF溶液中蚀刻期间GaAs上的砷形成】
到目前为止,GaAs晶片的直接再利用受到晶片表面上的残留物的限制,这些残留物不能利用一般的清洗方法方式去除。因此,用显微技术、轮廓术和x光电子能谱研究了氢氟酸对GaAs晶片的腐蚀。发现在蚀刻之后,晶片表面立即被元素碑的棕色层覆盖。该层的厚度和均匀性取决于蚀刻过程中的光照和氟化氢浓度。在存储蚀刻晶片的过程中,碑层被三氧化二碑颗粒代替。结果表明,只有当晶片暴露在空气中的光线下时,才会形成氧化物颗粒。
实验
所有实验均在1 x 1 cm- n型GaAs样品上进行,所有样品均由新的( 100)GaAs晶片制备。每个样品的一角都覆盖有光刻胶,以防止在该位置蚀刻。去除光致抗蚀剂后,蚀刻速率会降低,通过测量样品的掩蔽角和蚀刻部分之间的台阶高度来确定。所有实验都是通过将GaAs样品面朝上放置在容器中,并从储备溶液中加入6毫升水中的氟化氢溶液来进行的。通常使用20%的氟化氢浓度。蚀刻剂是在室温约21℃下使用,在实验过程中不搅拌。
冲洗样品后,立即用棉签在样品上的三个位置重新移动棕色层,测量沉积物厚度。因为这个厚度是用轮廓仪测量的。这是蚀刻后,样品储存不同的时间在环境条件下(即,当暴露于光和空气中时,以及在室温下),除了将样品保持在无氧条件下(N2净化气氛,氧浓度<5 ppm)和/或在黑暗中的一 一些储存实验。照明由环境光(荧光灯)提供,在GaAs光电二极管上产生0.09毫安/平方厘米的短路电流密度。
使用MatLab算法分析光学显微照片中的粒子形成。直接的分割. 方法是将图像转换为灰度,然后通过强度(灰度值)的差异将粒子从, 背景中分离出来。然而,这没有考虑背景的不均匀性,例如,如图1a所示,其中中心的背景比图像边缘的背景亮。

文章插图
结果和讨论
在实验中,样品要么在黑暗中蚀刻,要么暴露在环境光下。所有样品的蚀刻速率相当,但观察到蚀刻表面上形成的棕色沉积物存在显著差异。在光照下蚀刻时,会形成一层薄而均匀的层,而在黑暗中蚀刻会产生较厚的不均匀沉积物,表面上有一些裸露的区域,如图2。扫描电镜分析表明,棕色沉积物表面由小丘组成。
考虑到ELO过程中的光照条件(环境光),所有后续样品在蚀刻过程中都暴露在光线下。样品在不同HF浓度的溶液中蚀刻不同的时间,以研究蚀刻速率和沉积层厚度。改变储存条件(光照和暴露在空气中)以确定这些因素对颗粒形成的影响。在图3和4中,GaAs蚀刻深度和沉积物厚度在蚀刻之后,对于三种HF浓度,蚀刻速率是蚀刻时间的函数。这些数据点是针对不同的GaAs样品,即从蚀刻剂中取出的样品没有被再次浸入以进行进一步蚀刻。可以看出,GaAs蚀刻深度增加在时间上是线性的,表示大约16nm/小时的恒定蚀刻速率。 仅观察到蚀刻速率和蚀刻剂中的HF浓度之间的微弱关系。棕色沉积物的厚度随时间增加,但在大约7小时的蚀刻后趋于20-30纳米范围内的恒定值。
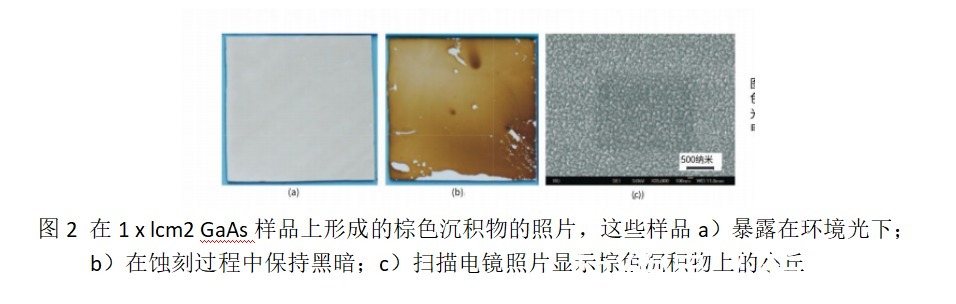
文章插图
考虑到ELO过程中的光照条件(环境光),所有后续样品在蚀刻过程中都暴露在光线下。样品在不同HF浓度的溶液中蚀刻不同的时间,以研究蚀刻速率和沉积层厚度。改变储存条件(光照和暴露在空气中)以确定这些因素对颗粒形成的影响。在图3和4中,GaAs蚀刻深度和沉积物厚度在蚀刻之后,对于三种HF浓度,蚀刻速率是蚀刻时间的函数。这些数据点是针对不同的GaAs样品,即从蚀刻剂中取出的样品没有被再次浸入以进行进一步蚀刻。可以看出,GaAs蚀刻深度增加在时间上是线性的,表示大约16nm/小时的恒定蚀刻速率。 仅观察到蚀刻速率和蚀刻剂中的HF浓度之间的微弱关系。棕色沉积物的厚度随时间增加,但在大约7小时的蚀刻后趋于20-30纳米范围内的恒定值。
- text|《2021大数据产业年度创新技术突破》榜重磅发布丨金猿奖
- 《吉星高照》的谢怜杀青啦,半年的拍摄
- 小米12|自研动态性能调度!小姐姐实测小米12 Pro《王者荣耀》:功耗下降20%
- 《消逝的光芒》开发商保证:游戏将获得 5 年的后续内容更新
- 《长津湖之水门桥》释出终极海报及剧照:准备战斗
- 今日|《战神4》pc版正式解锁dlss和fsr性能表现
- 《三生有幸遇上你》大结局:侯爵遇险,十一舍命相救
- 上海尊宝音响多款产品获《影音极品》器材大赏奖项
- 拯救者|首款无挖孔骁龙8旗舰!拯救者Y90实测30分钟《原神》平均帧率59.2
- 创新大赛|RTE创新大赛三强揭晓 !《实时互动场景创新生态报告》重磅发布
