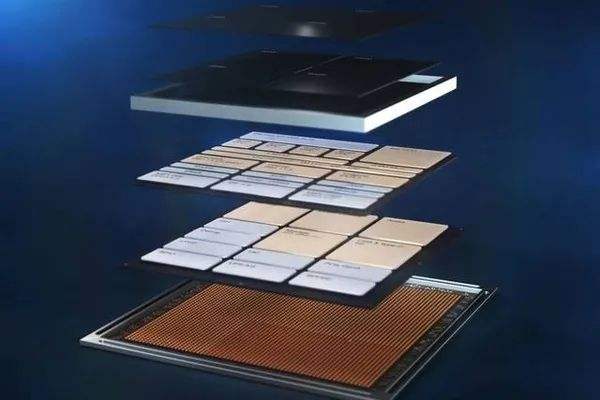
文章图片
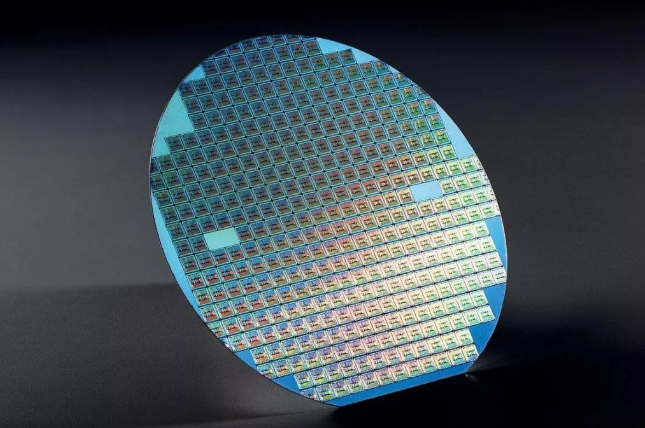
有关这个话题的想法是从去年开始的 , 当时受制于美国的压力 , 华为所设计的芯片已经找不到合适的代工企业了 , 市面上也开始有相关的华为要自行组建代工生产线的消息 , 当时我就想 , 如果要想实现自己制造 , 华为就必须大量突破有关芯片代工的专利 , 否则组建代工厂 , 几乎是不可能的 , 不要小看了一个代工厂 , 就像台积电、三星等企业一样 , 如果没有相关的技术专利积累 , 他们不可能走到今天 。
所以说 , 技术创新、打破技术壁垒是组建代工厂的关键 , 很明显 , 当时的华为做不到 , 那么现在呢?最起码现在看一些公开资料 , 华为还是做不到 。
即便如此 , 大家还是没必要着急 , 因为华为自己对相关的技术突破有自己的长远想法 , 既然一时半刻难以成功 , 还不如先换一个赛道 , 等到技术积累够了 , 再考虑自建代工厂也不迟 。
所以说 , 现在最关键的就是这个新赛道的问题 , 是哪一个赛道呢?这就是已经传言了很久的芯片叠加技术 , 换句很多人理解却又有很多人嗤之以鼻的说法:两个14nm的芯片 , 叠加到一起 , 当作7nm的芯片使用 。
至于性能是和7nm差不多 , 还是更胜一筹 , 又或者是稍次一些 , 这些都不是关键了 , 关键是这个方法是否可行?这就是大家争议的地方 , 其中喊得最响的争议就是“一个芯片发热问题还难以控制呢 , 要是两片叠加到一起 , 岂不是更烫 , 十有八九会烧坏的” 。
至于说的对不对 , 我觉得这个不能说对 , 也不能说不对 , 因为出现散热问题是必然的 , 关键在于能否解决这些散热问题 , 很明显 , 华为正在尝试解决这个难题 。 我简单梳理了一下仅仅今年一年时间 , 华为在这个领域申请的相关的技术专利 , 还是可以看出一些端倪的:
1、“芯片及其制备方法、电子设备”专利 , 用于解决裸芯片上出现裂纹 , 导致裸芯片失效的问题 , 可以提升芯片强度 , 解决裂纹;
2、“一种芯片的同步方法及相关装置\" 专利:可用于降低芯片设计和布局时的复杂度 , 摘要中涉及到第一以及第二芯片;
3、“封装芯片及封装芯片的制作方法”专利:该技术可用于芯片的后期封装、测试 。
4、“芯片封装组件、电子设备及芯片封装组件的制作方法”的专利 , 主要用于芯片封装组件能够达到更优的散热效果 。
5、“一种检测芯片裂缝的装置”专利 , 可以在实现裂片检测的同时 , 降低对功能电路造成的干扰 。
很明显 , 华为已经投入了大量的资源在这个领域 , 目的就是获得突破 。
其实芯片叠加技术不是华为先想到的 , 无论是英特尔还是高通 , 他们都有过这方面的研究 , 而且还有不错的进展 , 而现在华为的芯片既然找不到代工厂了 , 那么只能退而求其次 , 努力去解决叠加芯片的散热问题 , 这终究是一个技术创新问题 , 而只要是技术创新问题 , 那就存在获得突破的可能 。
其实这玩意还有一个我们平常人也可以理解的方向 , 厚度大的芯片在散热方面 , 总比厚度小的芯片存在更大的可以折腾的空间 。
【芯片|芯片叠加技术能否成真?汇总一下华为相关专利来分析】再看看华为这么多的相关专利 , 不就是可以说明了吗?
- text|《2021大数据产业年度创新技术突破》榜重磅发布丨金猿奖
- 芯片|上市仅4个月,跌价1000元,微云台主摄+6nm芯片+4400mAh
- iPhone|iphone14价格被曝!“胶囊”挖孔屏+三星4nm芯片,售价或5999起
- 信息科学技术学院|瞧不起中国芯?芯片女神出手,30岁斩获国际大奖,让美国哑口无言
- 元宇宙持续发酵,或迎“终极形态”?马斯克为何力挺脑机接口技术
- 400亿芯片交易接近尾声,英伟达、ARM表明态度,禁止收购后
- 芯片|据称索尼和台积电计划在日本投资70亿美元建芯片工厂
- 体验首款Linux消费级平板,原来芯片和系统全是国产
- 算力|不靠显卡!NVIDIA在中国焕发第二春:自动驾驶芯片被车厂爆买
- 自动驾驶|华为首秀自动驾驶,王兴:特斯拉遇到技术与忽悠能力相当的对手了
